Looking for Tiny Defects via Forward-Backward Feature Transfer

0

Sign in to get full access
Overview
- This paper explores a technique called "Forward-Backward Feature Transfer" to detect small defects in industrial images.
- The approach involves transferring features learned from a large dataset to a smaller, more specialized dataset to improve defect detection performance.
- The authors demonstrate the effectiveness of their method on two industrial inspection tasks: detecting small defects on steel surfaces and semiconductor wafers.
Plain English Explanation
The paper focuses on the challenge of detecting tiny defects in industrial settings, such as small imperfections on steel surfaces or semiconductor wafers. These tiny flaws can be difficult to spot, but they can have significant consequences if they go unnoticed.
To address this problem, the researchers developed a technique called "Forward-Backward Feature Transfer." The basic idea is to leverage the power of large, general-purpose datasets to help identify these tiny defects, even on specialized datasets with limited training data.
Here's how it works:
- The researchers first train a deep learning model on a large, diverse dataset of images. This allows the model to learn a rich set of visual features that are useful for a wide range of tasks.
- They then take the features learned by this model and "transfer" them to a smaller, more specialized dataset focused on the specific problem of detecting tiny defects.
- By combining the general features from the large dataset with the specialized training on the target dataset, the researchers are able to achieve better performance in detecting these tiny flaws compared to using the specialized dataset alone.
The key insight is that the features learned on the large, general dataset can help the model better recognize the subtle patterns and textures associated with tiny defects, even when the training data is limited. This "forward-backward" approach of transferring knowledge from a broad domain to a narrow one is the core innovation of this paper.
Technical Explanation
The paper starts by reviewing the existing literature on defect detection in industrial settings. The authors note that while there has been significant progress in using deep learning for this task, accurately identifying tiny defects remains a challenge, especially when training data is limited.
To address this, the researchers propose a "Forward-Backward Feature Transfer" (FBFT) approach. The core idea is to first train a deep learning model on a large, general-purpose dataset, such as ImageNet. This allows the model to learn a rich set of visual features that can be useful for a wide range of tasks.
The researchers then take the features learned by this "forward" model and use them to initialize a new model that is trained on the smaller, more specialized dataset focused on defect detection. This "backward" transfer of features from the general to the specific domain is the key innovation of the FBFT approach.
The authors evaluate their FBFT method on two industrial inspection tasks: detecting small defects on steel surfaces and semiconductor wafers. They show that FBFT outperforms traditional transfer learning and specialized training approaches, particularly when the target dataset is limited in size.
The paper also includes ablation studies and visualizations to provide insights into how the FBFT approach works and why it is effective for detecting tiny defects.
Critical Analysis
The paper makes a compelling case for the effectiveness of the FBFT approach in addressing the challenge of tiny defect detection. The authors provide thorough experimental results and analyses to support their claims.
One potential limitation of the work is that it is evaluated only on two specific industrial inspection tasks. While the authors argue that the FBFT approach should be broadly applicable, it would be valuable to see it tested on a wider range of industrial defect detection problems to further validate its generalizability.
Additionally, the paper does not deeply explore the underlying reasons why the FBFT approach is so effective for tiny defect detection. A more in-depth investigation into the feature transfer dynamics and the specific types of features that are most helpful for this task could provide additional insights and guidance for future research in this area.
Overall, the paper presents a promising technique that could have significant practical implications for improving the reliability and accuracy of industrial inspection systems. Further research to expand the scope of the evaluation and better understand the mechanisms driving the FBFT approach's success would be valuable contributions to this important problem domain.
Conclusion
This paper introduces a novel "Forward-Backward Feature Transfer" technique to improve the detection of tiny defects in industrial settings. By leveraging the power of large, general-purpose datasets to learn rich visual features, and then transferring those features to specialized models trained on limited target data, the researchers demonstrate significant performance gains compared to traditional approaches.
The findings of this work could have important real-world implications, as the ability to reliably detect small flaws in industrial products and processes can help prevent costly failures, improve quality control, and enhance overall manufacturing efficiency. The FBFT method represents an important step forward in addressing this challenging problem, and further research to expand its scope and deepen the understanding of its inner workings could lead to even more impactful advancements in the field of industrial inspection and defect detection.
This summary was produced with help from an AI and may contain inaccuracies - check out the links to read the original source documents!
Related Papers


0
Looking for Tiny Defects via Forward-Backward Feature Transfer
Alex Costanzino, Pierluigi Zama Ramirez, Giuseppe Lisanti, Luigi Di Stefano
Motivated by efficiency requirements, most anomaly detection and segmentation (AD&S) methods focus on processing low-resolution images, e.g., $224times 224$ pixels, obtained by downsampling the original input images. In this setting, downsampling is typically applied also to the provided ground-truth defect masks. Yet, as numerous industrial applications demand identification of both large and tiny defects, the above-described protocol may fall short in providing a realistic picture of the actual performance attainable by current methods. Hence, in this work, we introduce a novel benchmark that evaluates methods on the original, high-resolution image and ground-truth masks, focusing on segmentation performance as a function of the size of anomalies. Our benchmark includes a metric that captures robustness with respect to defect size, i.e., the ability of a method to preserve good localization from large anomalies to tiny ones. Furthermore, we introduce an AD&S approach based on a novel Teacher-Student paradigm which relies on two shallow MLPs (the Students) that learn to transfer patch features across the layers of a frozen vision transformer (the Teacher). By means of our benchmark, we evaluate our proposal and other recent AD&S methods on high-resolution inputs containing large and tiny defects. Our proposal features the highest robustness to defect size, runs at the fastest speed, yields state-of-the-art performance on the MVTec AD dataset and state-of-the-art segmentation performance on the VisA dataset.
Read more7/9/2024
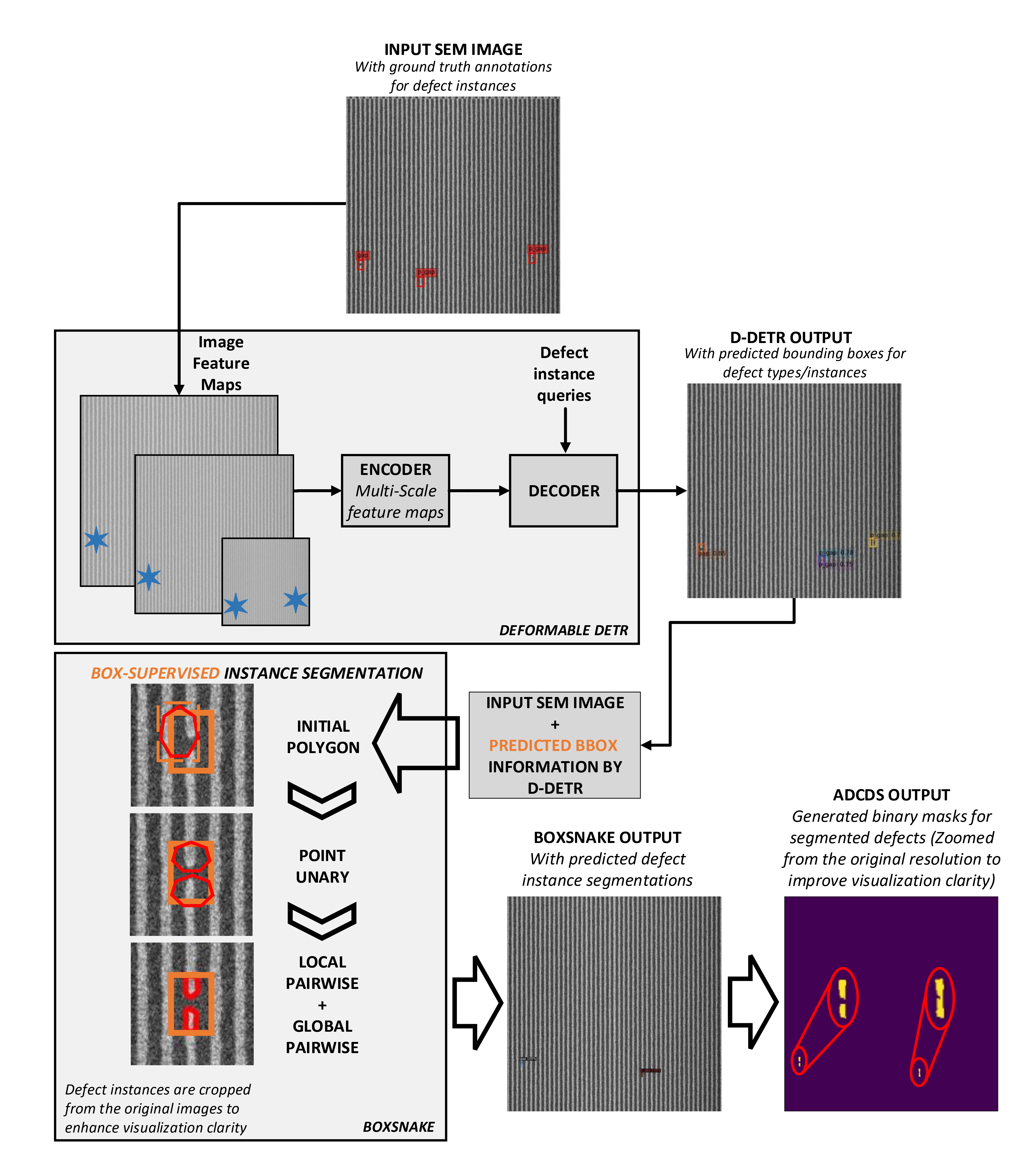

0
Advancing SEM Based Nano-Scale Defect Analysis in Semiconductor Manufacturing for Advanced IC Nodes
Bappaditya Dey, Matthias Monden, Victor Blanco, Sandip Halder, Stefan De Gendt
In this research, we introduce a unified end-to-end Automated Defect Classification-Detection-Segmentation (ADCDS) framework for classifying, detecting, and segmenting multiple instances of semiconductor defects for advanced nodes. This framework consists of two modules: (a) a defect detection module, followed by (b) a defect segmentation module. The defect detection module employs Deformable DETR to aid in the classification and detection of nano-scale defects, while the segmentation module utilizes BoxSnake. BoxSnake facilitates box-supervised instance segmentation of nano-scale defects, supported by the former module. This simplifies the process by eliminating the laborious requirement for ground-truth pixel-wise mask annotation by human experts, which is typically associated with training conventional segmentation models. We have evaluated the performance of our ADCDS framework using two distinct process datasets from real wafers, as ADI and AEI, specifically focusing on Line-space patterns. We have demonstrated the applicability and significance of our proposed methodology, particularly in the nano-scale segmentation and generation of binary defect masks, using the challenging ADI SEM dataset where ground-truth pixelwise segmentation annotations were unavailable. Furthermore, we have presented a comparative analysis of our proposed framework against previous approaches to demonstrate its effectiveness. Our proposed framework achieved an overall [email protected] of 72.19 for detection and 78.86 for segmentation on the ADI dataset. Similarly, for the AEI dataset, these metrics were 90.38 for detection and 95.48 for segmentation. Thus, our proposed framework effectively fulfils the requirements of advanced defect analysis while addressing significant constraints.
Read more9/9/2024


0
Feature Attenuation of Defective Representation Can Resolve Incomplete Masking on Anomaly Detection
YeongHyeon Park, Sungho Kang, Myung Jin Kim, Hyeong Seok Kim, Juneho Yi
In unsupervised anomaly detection (UAD) research, while state-of-the-art models have reached a saturation point with extensive studies on public benchmark datasets, they adopt large-scale tailor-made neural networks (NN) for detection performance or pursued unified models for various tasks. Towards edge computing, it is necessary to develop a computationally efficient and scalable solution that avoids large-scale complex NNs. Motivated by this, we aim to optimize the UAD performance with minimal changes to NN settings. Thus, we revisit the reconstruction-by-inpainting approach and rethink to improve it by analyzing strengths and weaknesses. The strength of the SOTA methods is a single deterministic masking approach that addresses the challenges of random multiple masking that is inference latency and output inconsistency. Nevertheless, the issue of failure to provide a mask to completely cover anomalous regions is a remaining weakness. To mitigate this issue, we propose Feature Attenuation of Defective Representation (FADeR) that only employs two MLP layers which attenuates feature information of anomaly reconstruction during decoding. By leveraging FADeR, features of unseen anomaly patterns are reconstructed into seen normal patterns, reducing false alarms. Experimental results demonstrate that FADeR achieves enhanced performance compared to similar-scale NNs. Furthermore, our approach exhibits scalability in performance enhancement when integrated with other single deterministic masking methods in a plug-and-play manner.
Read more7/8/2024


0
Towards Improved Semiconductor Defect Inspection for high-NA EUVL based on SEMI-SuperYOLO-NAS
Ying-Lin Chen, Jacob Deforce, Vic De Ridder, Bappaditya Dey, Victor Blanco, Sandip Halder, Philippe Leray
Due to potential pitch reduction, the semiconductor industry is adopting High-NA EUVL technology. However, its low depth of focus presents challenges for High Volume Manufacturing. To address this, suppliers are exploring thinner photoresists and new underlayers/hardmasks. These may suffer from poor SNR, complicating defect detection. Vision-based ML algorithms offer a promising solution for semiconductor defect inspection. However, developing a robust ML model across various image resolutions without explicit training remains a challenge for nano-scale defect inspection. This research's goal is to propose a scale-invariant ADCD framework capable to upscale images, addressing this issue. We propose an improvised ADCD framework as SEMI-SuperYOLO-NAS, which builds upon the baseline YOLO-NAS architecture. This framework integrates a SR assisted branch to aid in learning HR features by the defect detection backbone, particularly for detecting nano-scale defect instances from LR images. Additionally, the SR-assisted branch can recursively generate upscaled images from their corresponding downscaled counterparts, enabling defect detection inference across various image resolutions without requiring explicit training. Moreover, we investigate improved data augmentation strategy aimed at generating diverse and realistic training datasets to enhance model performance. We have evaluated our proposed approach using two original FAB datasets obtained from two distinct processes and captured using two different imaging tools. Finally, we demonstrate zero-shot inference for our model on a new, originating from a process condition distinct from the training dataset and possessing different Pitch characteristics. Experimental validation demonstrates that our proposed ADCD framework aids in increasing the throughput of imaging tools for defect inspection by reducing the required image pixel resolutions.
Read more4/10/2024